L.M.A.Means
 Deposition
Systems
Deposition
Systems
 Ion Beam Sputtering
system installed in a ISO3 clean room (size
2,4*2,4*2,2 m)- (c) Cyril Fresillon Photothèque CNRS
Ion Beam Sputtering
system installed in a ISO3 clean room (size
2,4*2,4*2,2 m)- (c) Cyril Fresillon Photothèque CNRS


 Dual Ion Beam Sputtering
system installed in a ISO3 clean room : model SPECTOR from IonTech (Veeco) (size:
diameter 1.1 m, height 0.9 m) - (c) Cyril Fresillon Photothèque CNRS
Dual Ion Beam Sputtering
system installed in a ISO3 clean room : model SPECTOR from IonTech (Veeco) (size:
diameter 1.1 m, height 0.9 m) - (c) Cyril Fresillon Photothèque CNRS
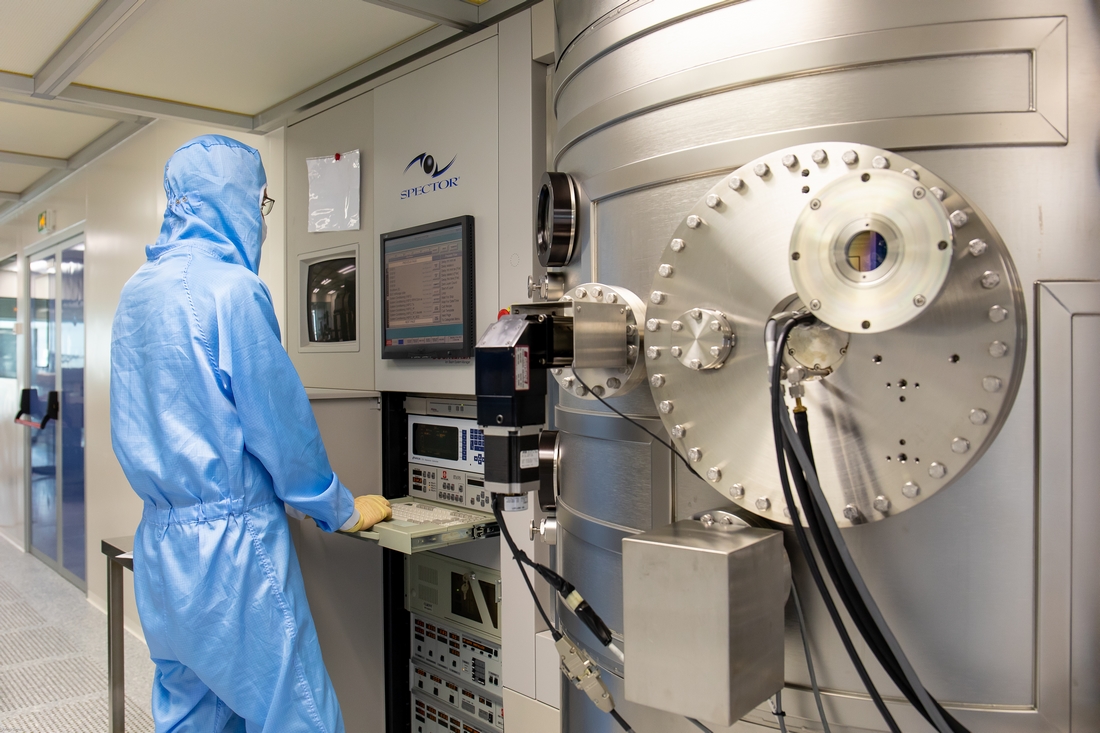
 Dual Ion Beam Sputtering
system installed in a ISO 3 clean room (size
0,6*0,6*0,8 m)
Dual Ion Beam Sputtering
system installed in a ISO 3 clean room (size
0,6*0,6*0,8 m)

 Ion Assisted Deposition system (VPTECH Citation 54") installed in a ISO 5
clean room - (c) Cyril Fresillon Photothèque CNRS
Ion Assisted Deposition system (VPTECH Citation 54") installed in a ISO 5
clean room - (c) Cyril Fresillon Photothèque CNRS

 Optical and Mechanical Characterizations
Optical and Mechanical Characterizations
 Absorption PDS (Photothermal Deflection System) benches at 1064 nm and 1,5 µm - Mapping possible up
to 30 cm in diameter - Surface and volume measurement
Absorption PDS (Photothermal Deflection System) benches at 1064 nm and 1,5 µm - Mapping possible up
to 30 cm in diameter - Surface and volume measurement


 Scatterometer
CASI (ScatterWorks, ex TMA) at 633 nm, 1064 nm - Mapping possible on 40 cm in diameter
Scatterometer
CASI (ScatterWorks, ex TMA) at 633 nm, 1064 nm - Mapping possible on 40 cm in diameter

 ZYGO wavelength shifting
interferometer (VERIFIRE) with a 18" beam expander (1064 nm), pupil diameter 450 mm: measurement of surface flatness below 0.5 nm RMS
ZYGO wavelength shifting
interferometer (VERIFIRE) with a 18" beam expander (1064 nm), pupil diameter 450 mm: measurement of surface flatness below 0.5 nm RMS

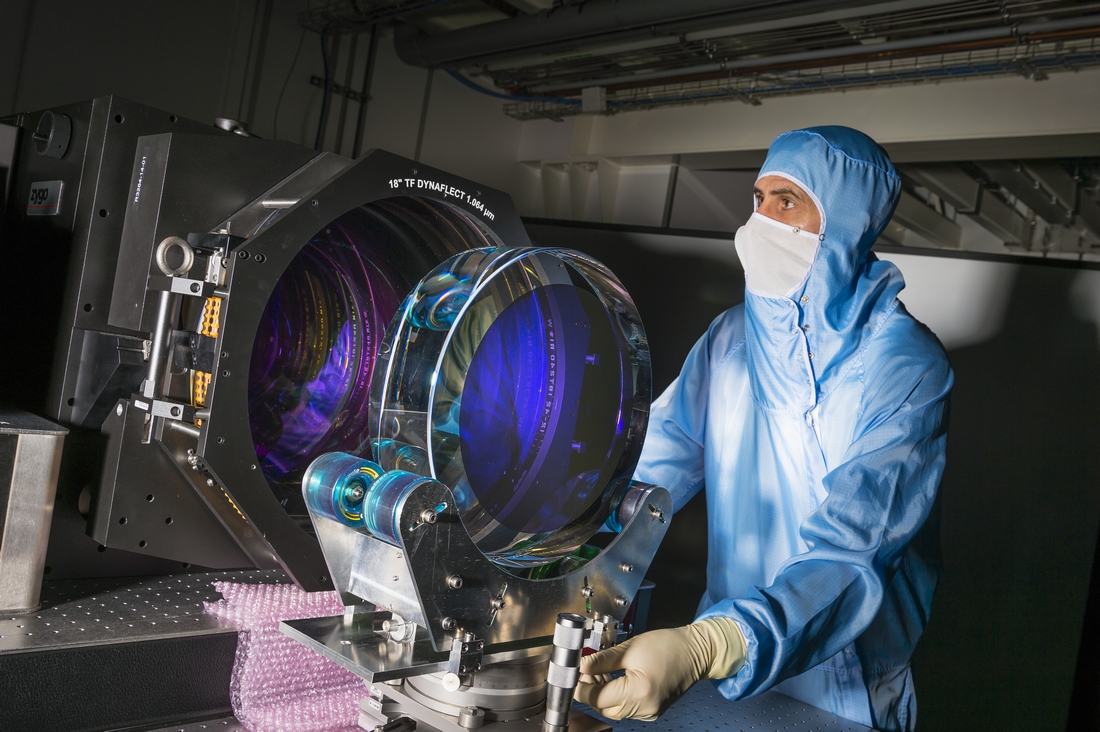
 Phase
Shift interferometer model MINIFIZ(1064 nm), pupil diameter 150 mm
Phase
Shift interferometer model MINIFIZ(1064 nm), pupil diameter 150 mm


 OBSERVE bench(ESA) to measure the
wavefront error of mirrors every nm from 510 to 950 nm, with variable incidence and variable polarization - Bench developed
by the company IMAGINE OPTIQUE and installed at the LMA in the ISO3 clean room (bench developed to measure the Dichroic of the EUCLID satellite)
OBSERVE bench(ESA) to measure the
wavefront error of mirrors every nm from 510 to 950 nm, with variable incidence and variable polarization - Bench developed
by the company IMAGINE OPTIQUE and installed at the LMA in the ISO3 clean room (bench developed to measure the Dichroic of the EUCLID satellite)

 UV-Visible-Near
IR spectrophotometer Lambda 1050 PERKIN-ELMER (3200-200 nm), three detectors available, URA accessory (Absolute reflectivity
measurement available)
UV-Visible-Near
IR spectrophotometer Lambda 1050 PERKIN-ELMER (3200-200 nm), three detectors available, URA accessory (Absolute reflectivity
measurement available)

 spectrophotometer
UV-Visible-Proche IR CARY 7000 Universal Measurement Spectrophotometer (UMS) AGILENT (3300-175 nm),
spectrophotometer
UV-Visible-Proche IR CARY 7000 Universal Measurement Spectrophotometer (UMS) AGILENT (3300-175 nm),

 Microscope optique Leica Leica DM6/M optical microscope, able to measure defects up
to a size of 5 µm, automatic scanning of surfaces.
Microscope optique Leica Leica DM6/M optical microscope, able to measure defects up
to a size of 5 µm, automatic scanning of surfaces.

 Optical profilometer
EOTECH - Microroughness measurement, Defects maps of 500*500 mm
Optical profilometer
EOTECH - Microroughness measurement, Defects maps of 500*500 mm


-
 Three benches to measure the mechanical Quality factor Q (mechanical loss angle) based
on the GeNS (Gentle Nodal Suspension) technique, measurements at room temperature and cryogenic temperature
Three benches to measure the mechanical Quality factor Q (mechanical loss angle) based
on the GeNS (Gentle Nodal Suspension) technique, measurements at room temperature and cryogenic temperature
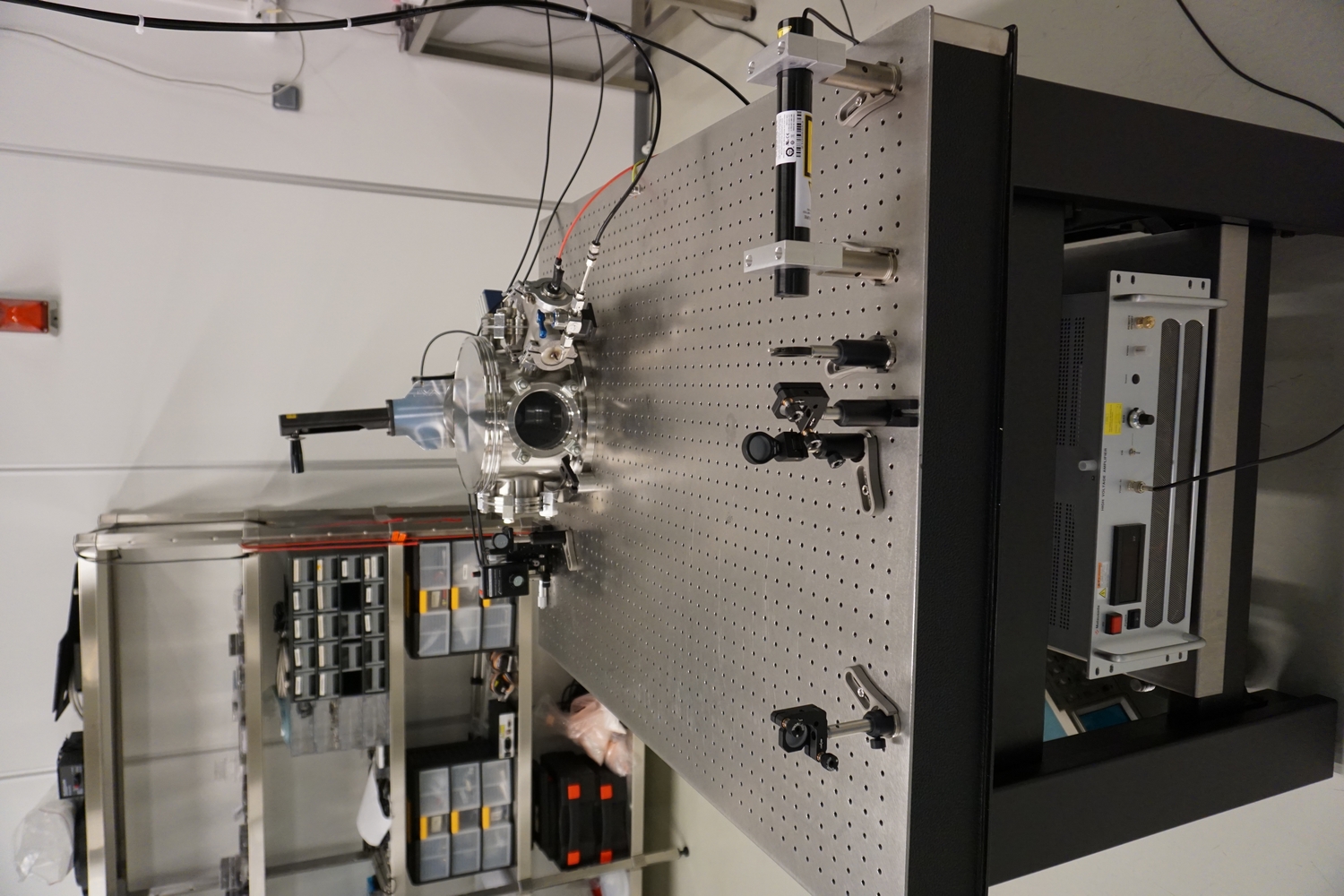
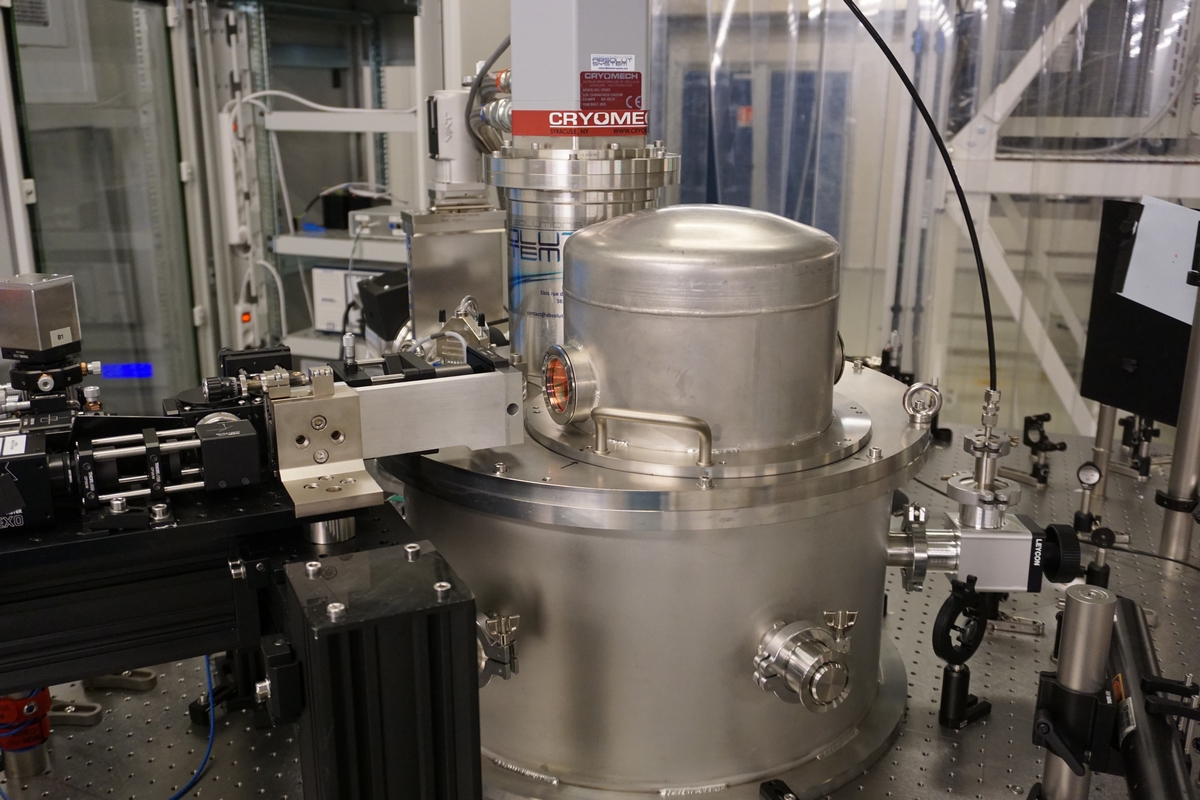
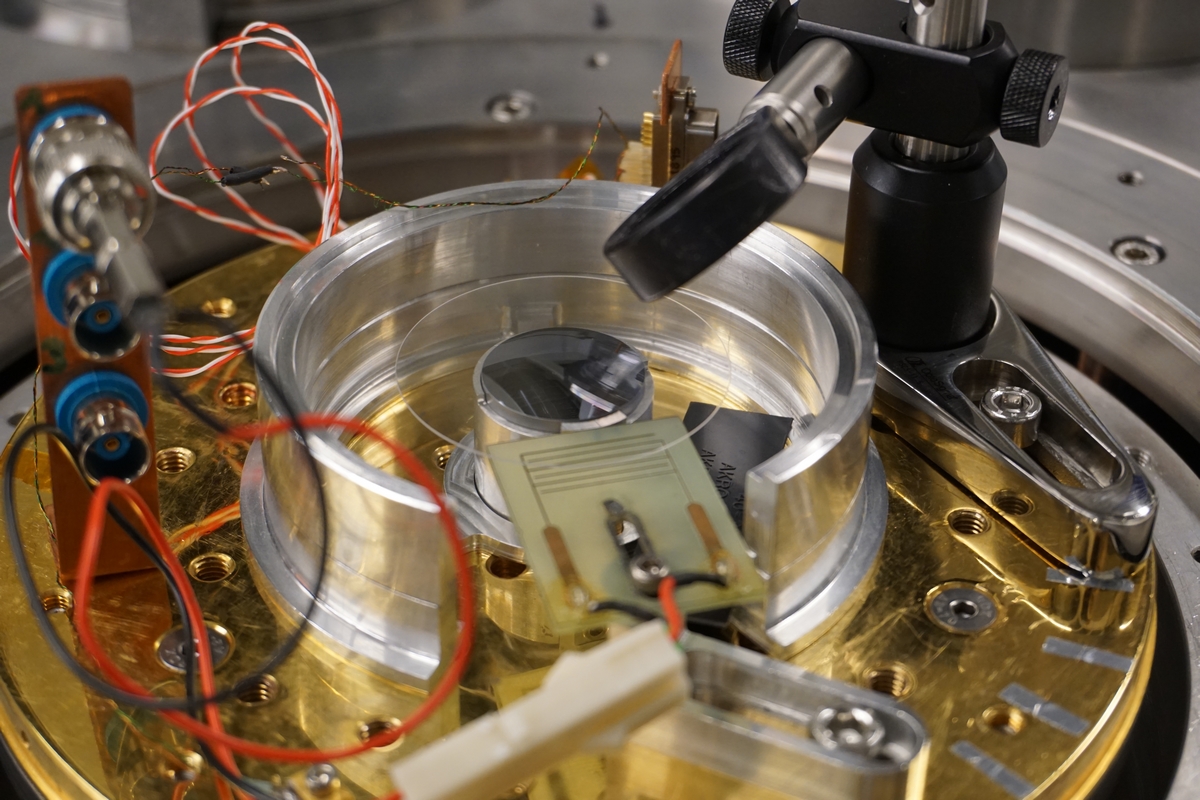
 Simulation program
ot thin films (calcul and optimization of any type of multilayers with OPTILAYER and TFCALC)
Simulation program
ot thin films (calcul and optimization of any type of multilayers with OPTILAYER and TFCALC)






